应变和V形坑结构对氮化镓(GaN)基发光二极管性能的影响
可供蓝宝石基氮化镓(GaN)基发光二极管外延片,具体外延结构及参数信息请联系我们的销售团队:vp@honestgroup.cn
1. 概述
应变和V形坑是决定氮化镓(GaN)基发光二极管(LED)效率的重要因素。在这项研究中,研究人员通过使用阴极发光(CL)、微光致发光(micro-PL)和深度分辨共焦拉曼光谱。结果表明,可以利用CL来分析V坑的形成情况。根据 CL 光谱中预应变层和多量子阱 (MQW) 的发射峰强度比,可以确定有关预应变层和 MQW 之间的应变弛豫的信息。
此外,还采用micro-PL和深度分辨共焦拉曼光谱来验证 CL 测量获得的结果。预应变层的生长条件在决定 LED 性能方面起着主导作用。厚 n-GaN 层的目的在于减少应变,但厚 n 型掺杂层中光吸收的增加抵消了这一点。因此,在预应变层生长温度相对较低的结构中观察到最令人满意的 LED 性能,该GaN LED结构表现出较大的 V 坑,从而导致更高的应变弛豫和更薄的 n 型 GaN 层,从而防止 n 型 GaN 引起的光吸收层。
2. 样品制备
通过金属有机化学气相沉积(MOCVD)在4英寸图案化蓝宝石(0001)衬底上生长GaN基LED的结构。所使用的Ga、In、Al和N的金属有机源分别为三甲基镓(TMGa)、三甲基铟(TMIn)、三甲基铝(TMAl)和氨(NH3)。硅烷(SiH4)和双环戊二烯基镁(Cp2Mg)分别用作n型和p型掺杂源。LED结构包括图案化蓝宝石衬底(节距=3.0μm、图案直径=2.8μm和图案高度=1.8μm的锥形图案)和通过物理气相沉积的25 nm厚的非原位AlN成核层。在LED生长中,非原位AlN层可以在随后的厚GaN层中提供比在低温下的传统GaN缓冲层更令人满意的晶体质量。在缓冲层之后,生长一层3μm厚的非故意掺杂的GaN层(u-GaN)。然后,分别在GaN LED结构中引入2、4和6μm厚(n掺杂浓度=2×1019cm−3)的n-GaN层,以制备LED结构A/D、B/E和C/F。
随后,分别在800°C和900°C下,用预应变层生长GaN LED A/B/C和D/E/F,预应变包括6对GaN/InGaN结构,分别具有9nm厚的n型GaN和2nm厚的非故意掺杂InGaN(u-InGaN)。生长总共10对具有3nm厚的u-InGaN阱和11nm厚的n-GaN势垒的InGaN/GaN MQW作为有源区。随后,生长4.5nm厚的p型Al0.2Ga0.8N作为电子阻挡层(EBL;p掺杂浓度=5×1019 cm−3)、20nm厚的p型GaN层(p掺杂浓度=1×1019cm−3),15nm厚的n型Al0.18Ga0.82N层(p掺入浓度=2×1020 cm−3)。
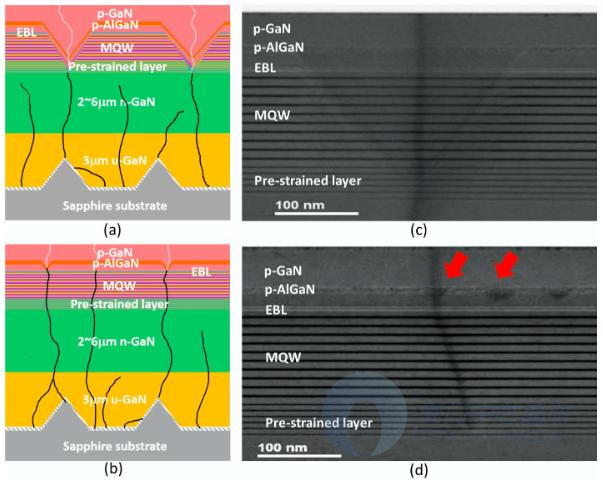
图1 LED 结构:( a ) 源自预应变层的大 V 形凹和 ( b ) 源自电子阻挡层 (EBL) 后的小 V 形坑,黑线说明了螺纹位错的传播;LED 晶片的 TEM 图像,具有 ( c ) 大 V 形坑和 ( d ) 小 V 形凹坑(红色箭头标注方向)

图2 LED 表面的阴极发光 (CL) 单色图像:大型 V 坑LED分别具有 ( a ) 2μm 厚、( b ) 4μm 厚和 ( c ) 6μm 厚的 n 型 GaN 层;小 V 坑LED分别具有 ( d ) 2 μm 厚、( e ) 4 μm 厚和 ( f ) 6 μm 厚 n 型 GaN 层
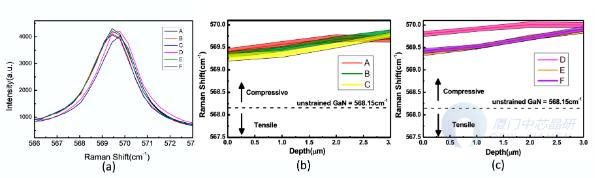
图3 ( a ) 所有GaN LED的 E2high拉曼峰的放大视图; ( b )GaN LED A/B/C(表面具有较大的 V 坑,表面拉曼位移通常为 569.2–569.4 cm -1 ); ( c ) D/E/F(具有较小的 V 坑)的GaN E2high的拉曼峰位移V 坑(表面拉曼位移通常为 569.4–569.8 cm -1),绘制为 LED 结构从表面 (0 μm) 到衬底的深度函数

图4 在 10 K 下测量GaN LED ( a ) A/B/C 和 ( b ) D/E/F 的 CL 光谱;GaN LED A 在 ( c ) 386 和 ( d ) 435 nm处的 CL 光谱带的空间分布;GaN LED D 在 ( e ) 389 和 ( f ) 438 nm 处的 CL 光谱带的空间分布
 图5 GaN LED ( a ) A/B/C 和 ( b ) D/E/F 的 PL 光谱;MQW 的归一化内量子效率 (IQE) 值与GaN LED ( c ) A/B/C 和 ( d ) D/E/F 在 12 K 和 300 K 下的泵浦功率的函数关系
图5 GaN LED ( a ) A/B/C 和 ( b ) D/E/F 的 PL 光谱;MQW 的归一化内量子效率 (IQE) 值与GaN LED ( c ) A/B/C 和 ( d ) D/E/F 在 12 K 和 300 K 下的泵浦功率的函数关系
3. 结论
InGaN MQW 中的应变弛豫和 V 形坑的形成是通过预应变层的生长温度来控制的。较低的预应变层生长温度有效地提供了更令人满意的应变松弛和更大的V形坑。
CL测量表明,预应变层和MQW的峰值强度可用于确定应变松弛水平和V形坑的原始位置。此外,深度分辨拉曼测量表明,在厚的n型GaN层中可以实现较小的应变。然而,厚的 n-GaN 层导致相对较高的光吸收损耗,限制了 LED 性能。
最终结果显示,具有大V坑GaN LED比具有小V坑GaN基LED表现出更令人满意的光输出功率,并且利用最薄的n型GaN层和较低的预应变层生长温度获得了704 mW的最高功率(导致大V形坑)。这项系统研究将预应变层的出色应变释放与 n 型 GaN 厚度适当结合起来,以获得高性能GaN基LED,为设计 LED 结构提供了指南和测量程序。
更多蓝宝石基GaN LED外延片信息或疑问,请邮件咨询:vp@honestgroup.cn
