亚皮秒(sub-ps)脉冲激光剥离对 InGaN/GaN 发光二极管电学和光学性能的影响
可供InGaN/GaN发光二极管外延片用于电学和光学研究,具体规格参数请联系:vp@honestgroup.cn
1. 概述
激光剥离(LLO)是氮化物基发光二极管(LED)加工链中的一个重要步骤,因为它能够将LED从生长衬底转移到更合适的载体上。超短脉冲激光剥离的一个显著特征是能够使用带隙以上或带隙以下的辐射,因为非线性吸收与超短脉冲相关。本研究解决了带隙以下和带隙以上辐射吸收方案的差异,并研究了347nm和520nm 激光LLO前后InGaN/GaN LED的电学和光学特性,并通过电流-电压和功率以及温度相关的光致发光测量。LLO可以用两种波长成功地实现。与 347 nm 相比,520nm LLO 所需的阈值注量大约是其的两倍。此外,对于带隙以下的辐射,观察到泄漏电流增加了几个数量级,并且随着激光注量而效率显著降低。相反,对于使用347nm提升的LED,漏电流几乎不会增加,效率对激光通量的依赖性也较小。这种退化归因于活性区域中激光的吸收,这有助于局部缺陷景观的改变。随着更多的激光深入结构并到达有源区,带隙以下辐射的影响更为严重。最终,证明了用超短激光脉冲提升的LED可以表现出良好的质量,使超短脉冲LLO成为传统纳秒脉冲LLO的可行替代品。
2. 样品制备
研究了通过金属有机气相外延在 c 取向蓝宝石衬底上生长的平面蓝光InGaN/GaN LED。 LED 堆叠由约 4.7 μm厚的 n-GaN 层、四倍 InGaN/GaN 多量子阱 (MQW) 结构、约 23 nm 厚的 AlGaN 电子阻挡层和约 100 nm 厚的 p-GaN 层组成。 MQW 结构代表有源区,其势垒厚度和阱厚度分别约为 10-11nm 和 2.5-3.0 nm。
对于电气测量,标准化 LED 器件是在 2 英寸的衬底上制造的,晶圆根据图1(a)所示的设计。通过使用铬硬掩模进行氟基反应离子蚀刻,蚀刻至约 1.8 μm的深度 ,然后通过电子束蒸发在蚀刻区域上沉积 Ti/Au 接触,从而制造出与 n-GaN 的接触。采用 Pd/Au 金属化作为与 p-GaN 的接触。处理后,晶圆被切割成0.5 × 0.5或1 × 1 cm 2尺寸的芯片,如图1(b)所示,并在LLO之前使用配备半导体表征系统的探针台记录I-V曲线。随后,使用 Crystalbond 将芯片粘合到中间硼硅酸盐玻璃载体上,以便为分离的 GaN 薄膜提供机械支撑,如图1(c)所示。
然后,进行LLO,具体如下所述,并使用苯并环丁烯(BCB)作为粘合剂进行第二粘合步骤,如图1(e)所示。 BCB 在 200 °C 的温度下固化 30 分钟,用杠杆压到背面。 Crystalbond 在这些温度下再次软化,因此中间载体可以在热处理后直接轻松去除。随后将剩余的Crystalbond粘合剂溶解在丙酮中。这样,LED器件被翻转两次,再次提供对接触焊盘的访问,如图1(f)所示。通过这种方法,可以测量 LLO 后的 I-V 曲线并与原始曲线进行比较。对于 PL 测量,使用了 LED 晶圆的非结构化芯片。仅需要 LLO 之前的第一个键合步骤,因为激发激光的紫外光以及发射的光致发光可以在 LLO 之后穿过 GaN 缓冲层,而没有明显的吸收。在这种情况下,Crystalbond 直接被 BCB 取代,BCB 具有更好的机械和化学稳定性。

图1 (a) 用于 I-V 测量的标准化 LED 的显微图像,以确定 LLO 对电气特性的影响; (b)–(f) 描述如何准备标准化 LED 以进行蓝宝石去除后的电气特性表征的工艺流程
LLO 是使用超短脉冲激光器(光谱物理,Spirit)进行的,该激光器基于包含掺镱晶体的再生放大器并发射波长为 1040 nm 的红外光。使用非线性晶体将其激光转换为二次谐波 (520 nm) 或三次谐波 (347 nm)。通过自相关测量验证,谐波的基频脉冲宽度保持在 ~0.4 ps。激光束聚焦在蓝宝石和 GaN 之间的界面上,并以密集、规则的撞击脉冲图案横向扫描整个界面。当沉积的注量至少与 LLO 阈值注量一样大时,GaN 会分解为其元素成分。与蓝宝石衬底分离后,现在暴露的 GaN 缓冲液在盐酸中清洗,以去除 LLO 过程中形成的多余金属镓。
在光致发光实验中,使用波长为375 nm的连续波二极管激光器作为准谐振激发源,其光通过5×物镜(NA = 0.12)聚焦到样品上。LED上产生的激光焦斑可以近似为长轴和短轴分别为 30 和 20 μm的椭圆。从样品发出的 PL 信号由物镜收集并传递到 320 mm 焦距光谱仪(Horiba,iHR320),该光谱仪使用冷却至 -50 °C 的附带 CCD(Horiba,Syncerity)记录光谱。将样品安装在闭式循环液氦低温恒温器(attocube,attoDRY800)内的载物台上,该恒温器允许温度在〜5-300 K的范围内变化。此外,使用光学显微镜设置监测样品使用压电执行器校正不同温度下测量之间的热漂移,并保持激励条件尽可能相似。由于 InGaN/GaN LED 的内量子效率 (IQE) 对注入载流子密度非常敏感,因此在每个温度下以不同的激发功率进行测量。这是通过改变激光功率并将中性密度滤光片插入光束路径来实现的,将测量范围扩展到激发功率密度从~0.008至1180 W/cm 2。
3. 结论
研究了超短亚皮秒脉冲LLO对蓝光InGaN/GaN LED电学和光学特性的影响。实验使用了两种不同的波长,对应于所用激光系统的二次和三次谐波,分别为520nm和347nm。
正如预期的那样,研究者观察到347 nm处带隙以上辐射的 LLO 的阈值注量低于 0.2 J/cm 2(每脉冲峰值注量),而520 nm处带隙以下辐射则需要稍高的值。重要的LED参数对 LLO 工艺的响应差异很大:在347 nm的LLO后几乎没有发生任何额外的泄漏路径,并且即使在应用高激光能量密度时,由温度相关PL确定的IQE也仅略有下降。在520 nm处,随着注量的增加,观察到泄漏量显着增加,同时 IQE 降低多达两倍以上。

图2 在不同条件下,使用图1中的双翻转程序在没有LLO和LLO之后的标准化LED结构上获得的I–V曲线。(a)显示了没有LLO的参考LED与在347nm处提升的LED的比较,而(b)与在520nm处提升LED的比较
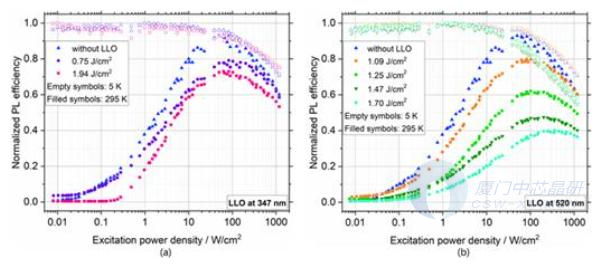
图3 激发功率密度在0.008至1180W/cm2范围内,对于没有LLO的样品和LLO之后的GaN LED(a)在347nm和(b)在520nm的5K(空符号)和室温(填充符号)下的归一化PL效率曲线
最大内量子效率ηintmax和(b)最大内部量子效率Pexmax下的激发功率密度.png)
图4 对于没有LLO和LLO之后的LED器件:(a)最大内量子效率ηint,max和(b)最大内部量子效率Pex,max下的激发功率密度
此外,通过 PL 测量可以观察到光提取的强烈变化。研究人员将带隙以下辐射情况下材料质量的显着下降归因于较长的光学吸收范围,甚至在GaN层深处和LED的有源区域中引入了额外的缺陷和局部缺陷形貌的改变。
和(c)347nm激光、(b)和(d)520 nm激光LLO之后,在激光剥离期间fs激光聚焦在其上的GaN表面的示例性二次电子图像和AFM图像.png)
图5 在(a)和(c)347nm激光、(b)和(d)520 nm激光LLO之后,在激光剥离期间fs激光聚焦在其上的GaN表面的示例性二次电子图像和AFM图像 ;使用520nm激光进行激光剥离后,GaN晶片表面略微粗糙,出现坑洞效应效应。
所获得的结果强调,使用超短脉冲进行InGaN/GaN LED的LLO确实是传统纳秒脉冲LLO的可行替代方案。特别是,LED性能表明材料质量得到了保留,对于波长为347 nm的LLO的较大激光能量密度具有很强的恢复能力。此外,该研究还表明,即使使用低于带隙的LLO,蓝光LED原则上也可以表现出高效率。尽管材料质量的下降可能是一个问题,但这促使人们进一步在更具挑战性的材料系统中,例如AlN基器件,实现带隙以下的LLO。
更多InGaN/GaN发光二极管外延片信息或疑问,请邮件咨询:vp@honestgroup.cn
