如何测量毫米波下高纯半绝缘碳化硅晶片的介电性能?
可供低损耗高纯半绝缘碳化硅(SiC)晶片,具体规格请参考:https://www.cswafer.com/banjueyuandanjingtanhuaguichendicailiao/
1. 概述
本研究描述了一种用于在130到170GHz频率范围内精确测量非常低损耗材料的介电特性的系统。该系统使用了一个品质因数为~1×106的开放式谐振器。该谐振器的谐振曲线是通过配备外部毫米波谐波混频器的商用频谱分析仪获得的。激励源是通过数字锁相环锁定到频谱分析仪本地振荡器的后向波振荡器。该系统允许快速准确地测量谐振曲线线宽,允许确定10-6范围内的损耗角正切,报道了碳化硅(SiC)、CVD金刚石、蓝宝石和石英等的结果。
2. 样品制备与实验((以半绝缘SiC晶片为例)
该研究采用生产级高纯半绝缘4H-SiC晶片,其盘表面在小于0.50°范围内的{0001}平面上制造。测量的两个SiC晶片由来自不同的SiC晶体,但显示出非常相似的介电性能。
确定每个样品盘的共振波长。将半绝缘4H-SiC样品沿着轴平移到表面具有波腹的位置,即最大损耗位置,并测量谐振器的负载线宽。然后移除样品,并将谐振器长度增加相同模数下恢复谐振所需的量△D。谐振器的输入功率也被调节以将谐振曲线保持在恒定的最大振幅。后者是为了最小化检测过程中任何非线性的影响。然后测量空腔线宽,并使用相关公式来计算半绝缘4H-SiC样片厚度、指数和损耗角正切。所测得的数据如表1所示
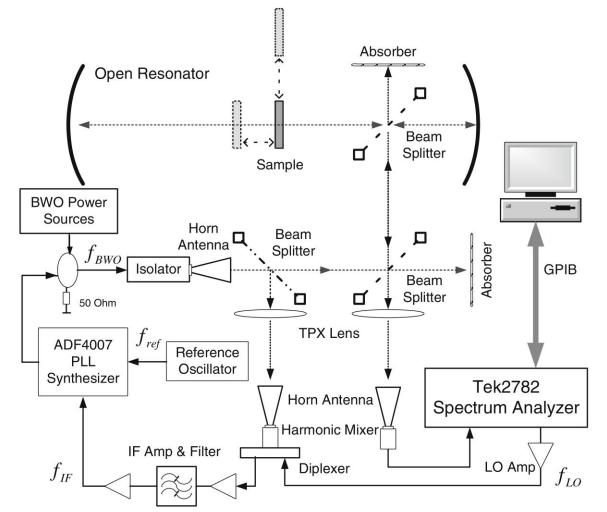
图1 测试系统结构示意图
| 表1 半绝缘4H-SiC介电性能 | |||||
| 样品 | fR(GHz) | 厚度(mm) | 折射率 | 损耗角正切 | |
| 样品1 | SiC(FW1244) | 136.747 | 0.354(0.001) | 3.099(0.009) | 6.2(0.2)x10-5 |
| 样品2 | SiC(FB0762) | 132.070 | 0.367(0.001) | 3.098(0.009) | 6.1(0.2)x10-5 |
毫米波长的自由空间测量的实际实施通常因杂散反射产生的大量驻波图案而变得复杂。对于图1所示的系统,有两个点需要注意。首先,来自两个吸收器的残余反射会干扰谐振器的回波,并在谐振曲线中产生不对称性。可以向拟合曲线添加校正以处理这种不对称性,但研究者发现,可以通过沿着光束轴平移其中一个吸收体来消除不对称性,从而在接收谐振器返回信号的混频器处产生驻波的最小值。所得到的谐振曲线由简单的洛伦兹函数很好地拟合,不需要任何校正。其次,根据反射波的相位,从混合透镜/喇叭反射回谐振器可以增加或减少测量的Q。通过总是调整混频器位置以在每个测量频率产生Q的最小值,这种可变性被最小化。调整为最小值还是最大值并不重要,但这种反射产生的效果总是相同的。这些对于每个共振频率需要一次调整,并且极大地提高了数据再现性。
图2中的曲线(a)和(b)分别显示了空谐振器和负载谐振器的单个数据扫描(圆)和相应的洛伦兹拟合(线)。请注意,在扫描之间调整功率以保持恒定的峰值振幅。图2中曲线的线宽相差44.2 kHz。用于加载扫描的样品是SiC样品2。这些扫描是在1.5MHz的跨度上进行的,扫描时间为3.3s。扫描可以在短至50ms的扫描时间内进行,但较长的扫描时间允许较窄的视频带宽以减少电子噪声,同时保持足够短以最小化热漂移的影响。计算机控制的数据收集协议获取并分析十次连续扫描。对得到的线宽进行平均以获得平均值和标准偏差。线宽的标准偏差小于1%。

图2 空载(a)和负载(b)共振曲线,功率调整以保持恒定的峰值振幅
3. 结论
先前的研究报道了33.5 GHz下高纯半绝缘4H-SiC的损耗角正切在300 K时为2×10-5。由于固有晶格损耗预计会随着频率的降低而降低,这与本研究在更高频率下的结果并不矛盾。早期对SiC的研究报告了更大的损耗。该研究中使用的高纯半绝缘4H-SiC样片来自同一制造商,但制造时晶片的法线与c轴倾斜8°。
Shu Chen等人报道的损耗角正切的最准确测量是在60 GHz下使用开放谐振器技术完成的,据报道精度为~±40×10-5,显然无法测量非常低的损耗。研究人员之前测量并报告了离轴高纯半绝缘4H-SiC的损耗正切值,未发现离轴样片和正轴样片之间的损耗存在显著差异。Shu Chen等人研究中报告的大损耗归因于自由载流子吸收,而此处和John G. Hartnett等人研究中观察到的低损耗水平与作为主要损耗过程的双声子本征晶格吸收一致。Charles R. Jones等研究人员目前正在完成对SiC中作为温度函数的损耗的研究,这似乎证实了两个声子的差异过程是主要的损耗机制。
更多半绝缘SiC衬底信息或疑问,请邮件咨询:vp@honestgroup.cn
参考文献:
Jones C R , Dutta J , Yu G ,et al.Measurement of Dielectric Properties for Low-Loss Materials at Millimeter Wavelengths[J].Journal of infrared, millimeter and terahertz waves, 2011, 32(6):838-847.DOI:10.1007/s10762-011-9795-4.
