基于不同In0.53Ga0.47As/InP异质结构的P-I-N红外光电二极管的特性*
1. 概述
在过去的二十年里,人们对InxGa1–xAs化合物的兴趣稳步增长,其中光敏性范围取决于X的摩尔分数。x=53的成分与InP晶格匹配,带隙为0.74eV,灵敏度范围为0.9-1.7μm。通常这些材料的基础工程是p-i-n二极管。在n+-或p+-型InP衬底上生长InGaAs异质结构(层的顺序、厚度和掺杂)具有多样化。这里需要注意的是i-InGaAs吸附层的厚度(从1到5μm)和杂质浓度(从1×1014到5×1017cm-3)。p-i-n光电二极管技术需要特殊的方法来形成p+-InP的欧姆接触。
本工作的目的是开发一种基于结构不同的InGaAs/InP异质结构的p-i-n光电二极管技术,并比较它们的电学和光学特性。
2. 样品制备
本研究使用MOCVD技术生长的InGaAs/InP异质外延材料(来自中芯晶研)制备p-i-n光电二极管。在Drone 3装置上通过X射线衍射法研究了结构的晶格质量。结果表明,主衍射峰具有百分之几度的窄宽度,这表明生长层的结构是完美的。然而,x值与所需值略有不同(+0.4%和-1.3%)。这表明晶格参数存在一定的失配,但不会影响材料的能带结构。
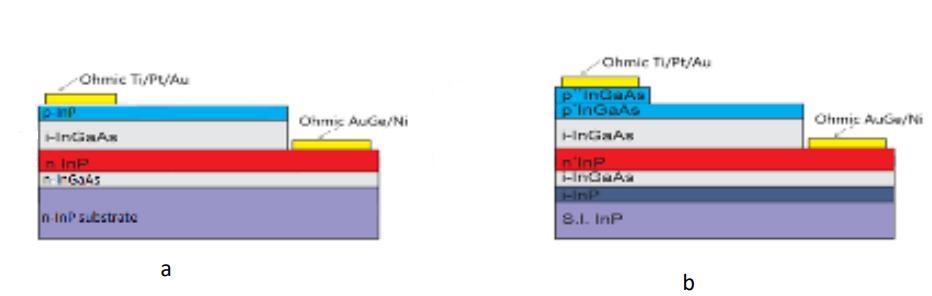
图1 p-i-n光电二极管的截面示意图:a)p+-InP/InGaAs/n+-InP(I型);b) 在半绝缘衬底上的p++-InGaAs/p+-InGaAs/InGaAs/n+-InP(II型)
使用剥离光刻法。选择了金属Ge/Au/Ni/Au(13/27/10/200nm)和与p+层-Ti/Pt/Au(20/30/150nm)的组成,以形成与n+层的欧姆接触。为了简化这项技术,开发了一种快速退火机制,可以在一个过程中形成两种类型的触点。同时,保持了金属表面的光滑形态。在不同的InGaAs和InP蚀刻剂中,通过液体选择性蚀刻进行了台阶(Mesa)蚀刻。
对I型和II型p-i-n二极管的I-V特性进行表征,并在MDR-2单色仪上使用TKS-5(850-3000 nm)滤光器测量的两种类型的p-i-n二极管的光敏光谱。

图2 p-i-n二极管的I-V特性:(a)I型结构(b)II型结构

图3 I型p-i-n二极管在300K和77K下的光敏光谱(相对单位)
.png)
图4 II型p-i-n二极管的光敏光谱(相对单位):a)在不同温度下;b) 在不同的光照条件下
3. 结论
本研究开发一种基于InGaAs/InP异质结构的p-i-n光电二极管的技术,获得I型和II型两种类型结构的二极管的比较特性和光敏光谱特性的新数据,并提出一种改进的接触层由р++-InGaAs和p+-InP组成的异质结构。
更多InGaAs/InP异质外延产品信息或疑问,请邮件咨询:vp@honestgroup.cn
