灰度硬掩模光刻技术在碳化硅(SiC)中可扩展地制造半球形固体浸没透镜*
1. 概述
灰度光刻允许在与标准光刻完全兼容的过程中创建具有空间控制高度的微米级特征。在这项研究中,使用一种结合灰度光刻和硬掩模技术的新型制造协议,在碳化硅(SiC)中演示了固体浸没透镜(SIL),以允许将半径为5µm的几乎半球形透镜蚀刻到衬底中。该技术具有高度可扩展性并与CMOS技术兼容,并且可以在抗蚀剂图案化之后通过控制随后的干蚀刻的化学来调节器件纵横比。这些结果为聚焦离子束铣削提供了一种低成本、高通量和工业相关的替代方案,用于创建高纵横比、圆形微观结构。
2. 样品制备
本工作采用来自我司的SiC外延材料(500µm衬底,具有15µm厚的外延层),切割成5×5 mm的芯片进行器件制造。在光刻之前,通过等离子体增强化学气相沉积在芯片上沉积5µm厚的二氧化硅(SiO2)层。
灰度级光致抗蚀剂(微抗蚀剂技术GmbH ma-P 1275G)在3000rpm下旋涂,厚度达到8µm,并在高达100℃的温度下进行软烘焙超过50分钟。
使用Heidelberg Instruments DWL66+直接写入激光光刻系统对抗蚀剂进行曝光。曝光光束以可变剂量在芯片上阶跃,允许抗蚀剂在显影后部分曝光空间可变高度。使用TMAH基溶剂(微抗蚀剂技术GmbH mr-D 526/S)对抗蚀剂显影5分钟,并在60℃下烘焙持续10分钟以使残留溶剂最小化。
随后将该芯片放到反应离子蚀刻系统中,其中使用25/7/3 CHF3/Ar/O2气体化学用作为掩模的灰度级光致抗蚀剂蚀刻SiO2层。在该蚀刻步骤中,CHF3以对光致抗蚀剂的高选择性蚀刻SiO2,而O2以对SiO2的高选择性来蚀刻光致抗抗蚀剂,从而允许取决于SiO2特征的期望高度的可调谐的总选择性。Ar气体在蚀刻过程中起到热链接的作用,以改善芯片冷却,同时提供少量的物理蚀刻。蚀刻继续进行,直到SiO2层被清除,理想情况下与通过光致抗蚀剂掩模层的蚀刻一致。
第二蚀刻步骤集中于将SiO2图案转移到SiC衬底中。对于该RIE步骤,使用SF6/Ar/O2化学,其中Ar再次作为热链接,O2起到致密等离子体和通过碳的化学蚀刻提高SiC蚀刻速率的作用。由于SF6以5-10的选择性优先蚀刻SiC而不是SiO2,因此该增益允许高选择性蚀刻步骤,尽管这可以通过将CHF3气体引入蚀刻来调节。
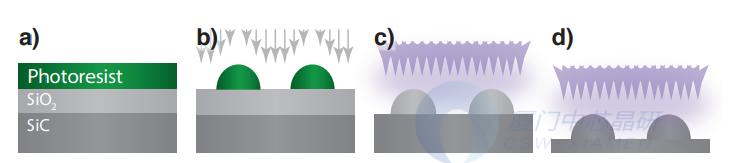
图1 通过灰阶硬掩模光刻在碳化硅中的半球形固体浸没透镜的制造流程图:(a)旋涂,(b)灰阶曝光和抗蚀剂显影,(c)用光致抗蚀剂作为掩模的SiO2层的干法蚀刻,(d)用SiO2作为灰阶硬模的碳化硅晶体的干法蚀刻
3. 结论
本研究证明了一种使用灰度光刻制造半球形固体浸没透镜的可扩展工艺,证明了单个发射器的光学收集效率约为4。该方法比离子束快得多,在形状控制方面比回流光刻等其他光刻方法更灵活。分析了随机定位发射器上的固体浸没透镜性能,而不是以透镜为中心:我们预计从配准到发射器位置的固体浸没透镜性能会大大提高。
虽然这项研究关注的是半球形固体浸没透镜,但我们的灰度硬掩模光刻协议非常灵活,可以实现更复杂形状的精确制造。未来的工作将能够优化固体浸没透镜形状(例如,允许椭圆,或锥形轮廓)和相邻结构,如沟槽,以将光重新引导到较低数值孔径的收集光学器件中。我们的技术可以进一步扩展到不同的材料,例如金刚石,只要使用SiO2掩模可以实现蚀刻选择性的充分平衡。
碳化硅的光子结构与微电子技术的集成,使控制发射极的电荷状态、调整发射波长和耗尽环境中的电荷成为可能,以最大限度地减少用于自旋-光子界面的自旋选择性类原子跃迁的光谱扩散。由于灰度硬掩模方法是可扩展的,并与标准光刻描记和CMOS过程兼容,因此可以将该协议与电子工作流程集成,允许芯片上的光子和电子元件共同定位,并使混合光子电子集成电路具有更大的灵活性。
更多SiC外延片信息或疑问,请邮件咨询:vp@honestgroup.cn
