硅基高效大功率氮化镓(GaN)绿光发光二极管(LED)的发展
可供硅基氮化镓(GaN)绿光发光二极管(LED)外延片,具体规格参数请联系:vp@honestgroup.cn
蓝宝石是当前商业化LED最常见的衬底,而硅(Si)和碳化硅(SiC)衬底LED也已工业化。在Si上生长GaN LED是一项具有挑战性的工作,因为GaN和Si之间的晶格失配和热失配都很大,但也有许多优点,具体如:
1)热导率:绿光LED的自热效应更严重,因为它们的效率低于蓝光LED;因此热传递是绿光LED的一个重要问题。蓝宝石衬底的导热系数较低,导致结温较高。温度的升高可能会极大地影响LED的性能。而硅具有高导热性,这对LED来说是不错的选择;
2)硅基LED可以容易地加工成垂直薄膜结构(VTF)。垂直薄膜结构 LED具有高的光提取效率、良好的电流扩展和较少的侧发射,这些共同使它们成为高质量的候选光源;
3)GaN和Si之间的晶格失配和热失配会在GaN中产生拉伸应变,这有利于量子阱生长和器件性能。在相同的发射波长下,硅衬底上LED的量子阱生长温度可以设定为比蓝宝石高20℃,这有助于提高量子阱的质量。在拉伸应变下生长的GaN薄膜可以补偿量子阱中的压缩应变,这也有利于光LED的性能。
1. 典型硅基绿光发光二极管外延与芯片结构
Si基绿光LED外延基本结构如图1所示。它从100nm厚的高温AlN缓冲层开始,然后生长2.4μm厚的Si掺杂n-GaN。之后,生长具有低温(LT)GaN层、10个周期的InGaN/GaN超晶格和6个周期的InGaN/GaN蓝光量子阱的应变层,有源区由7个周期的InGaN/GaN绿光量子阱和随后的AlGaN电子阻挡层(EBL)形成。最后,生长p-GaN以完成该结构。
外延结构和(b)芯片结构示意图.png)
图1 硅基绿光LED(a)外延结构和(b)芯片结构示意图
而后Si基LED晶片被加工成VTF-LED芯片,如图1(b)所示,将外延层结合在以Ag为反射器的导电Si基台上,并通过湿法蚀刻对顶表面进行粗糙化,这两种方法都可以提高光提取效率。电极是垂直排列的,这有利于电流扩散。
2. 硅基绿光发光二级管性能提升研究
研究人员从不同的方面进行了几个实验,以提高Si基绿光LED的性能。
2.1 n-GaN掺杂浓度对绿光LED器件性能的影响
n-GaN中Si的掺杂浓度是一个重要问题,因为它会影响LED中的载流子传输。n-GaN中的高载流子浓度导致低串联电阻和更好的电流扩展,但也可能导致较差的晶体质量和GaN膜破裂。在Si衬底上生长了两个结构相同但n-GaN掺杂水平不同的样品,两个样品的n-GaN Si浓度分别为2×1018cm−3和3×1018cm-3。扫描(002)和(102)平面的摇摆曲线以评估两个样品的晶体质量,并通过高分辨率XRD测量晶格参数。
当n-GaN中Si的掺杂浓度为2×1018cm−3时,(002)和(102)摇摆曲线的FWHM分别为345 arcsec和355 arcsec。可以说,由于LED结构的总厚度仅为3μm,GaN膜具有良好的晶体质量。当Si浓度增加到3×1018cm−3时,(002)和(102)摇摆曲线的FWHM分别增加到370 arcsec和380 arcsec。这意味着GaN的晶体质量随着n-GaN的掺杂浓度的增加而变差。通常,Si在晶格中取代Ga。由于Si原子的半径小于Ga原子的半径,更多的Si将导致较小的a轴晶格参数。
将这两个LED外延片制成具有相同结构的VTF LED。对LED的器件特性进行了测试。图2绘制了不同电流密度下的光输出功率(LOP)和正向电压。随着n-GaN中Si掺杂浓度的增加,LOP略有提高1%,这可能归因于较高n-GaN掺杂的电流扩展性更好;正向电压显著降低了3%,这主要是由于n掺杂浓度越高,串联电阻越低。

图2 不同n-GaN掺杂的光输出功率和正向电压的比较
将n-GaN掺杂浓度从2×1018cm-3提高到3×1018cm−3,LED的总效率提高了4%。但是进一步增加Si浓度可能导致GaN膜破裂和晶体质量变差。因此,设计了一种新的n-GaN结构,该结构由2.1μm厚的正常掺杂层(3×1018 cm−3 Si)和0.3μm厚重掺杂(HD)层组成。普通掺杂层可以将晶体质量保持在合理水平并防止膜破裂,而重掺杂层旨在提供高电子浓度。比较了HD-GaN的三种不同掺杂浓度,分别为3×1018、4×1018和6×1018cm−3。LED器件的测试结果如图3所示。随着HD-GaN中Si浓度的增加,LOP变化不大,当Si浓度增加到4×1018cm−3时正向电压下降,但当Si浓度进一步增加到6×1018cm-3时没有进一步变化。因此,HD-GaN的最佳掺杂浓度设定为4×1018cm−3。
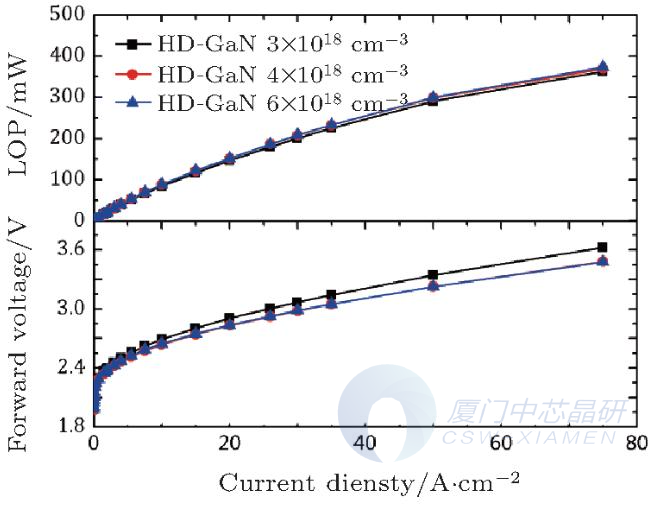
图3 不同重掺杂GaN的光输出功率和正向电压的比较
2.2 量子阱应变工程对GaN LED性能的影响
应变层由LT-GaN层、10个周期的InGaN/GaN超晶格和6个周期的蓝光量子阱组成。生长LT-GaN的目的是产生V形坑。V形坑是一种横截面看起来像“V”的空间缺陷,如图4所示。通常情况下,V形坑源自位错。在一定的生长条件下,GaN在该方向上的生长速率可以比[0001]方向上的增长速率小得多,从而形成六角金字塔形的凹坑。随着薄膜的变厚,V形坑的尺寸也变大。
示意性3D视图,(b)示意性横截面,(c)表面的AFM图像,以及(d)V形坑横截面的SEM图像.png)
图4 V形坑的图像:(a)示意性3D视图,(b)示意性横截面,(c)表面的AFM图像,以及(d)V形坑横截面的SEM图像
V形坑具有许多功能,其中之一是松弛应变。V形坑可以将量子阱从单个大面积分裂成小部分,阻止应力传播,并将长程应力转化为局部应力,从而有效降低量子阱中的应力。V型坑还可以钝化位错以降低非辐射复合率。V型坑的侧壁的较慢生长速率导致侧壁上具有较少铟含量的较薄量子阱。侧壁附近的电势将高于c平面量子阱的电势,因此更少的载流子将在位错附近重新结合。V形坑也可以有利于空穴注入,因为空穴可以通过侧壁传输到量子阱中。
生长了三个具有不同LT-GaN厚度的LED样品,分别为20 nm、50 nm和80 nm,以研究V形坑尺寸对绿光LED效率的影响。较厚的LT-GaN层表示较大的V形坑尺寸。三个样品的EQE如图5所示。观察到外量子效率(EQE)随着LT-GaN厚度的增加而增加,这意味着在绿光LED中更大的V形坑是优选的。

图5 不同LT-GaN厚度的绿光LED的EQE
应变蓝光量子阱对于松弛绿光量子阱的应变是至关重要的。具有与不具有蓝光量子阱作为预应变层的LED之间的效率存在显著差异。在此,研究人员研究了蓝光量子阱的厚度对绿光LED效率的影响。在Si衬底上生长了三个具有不同蓝光量子阱的绿光LED样品,三个样品的蓝光量子阱厚度分别为2.1、2.3和2.5nm。如图6所示。绿光LED的EQE随着应变层中蓝光量子阱的厚度的增加而增加。在较厚的蓝光量子阱中可以掺入更多的铟,因此可以松弛更多的应变。因此,具有最厚的蓝光量子阱的绿光LED具有最高的EQE。

图6 具有不同蓝光量子阱厚度的绿光LED的EQE
2.3 电子阻挡层(EBL)厚度对绿光LED性能的影响
EBL是GaN基LED中非常常见的结构,因为它可以有效地抑制从量子阱溢出的电子。在绿光LED中,压电场比蓝光LED大得多,导致更严重的电流泄漏。因此,应该重新设计EBL层以提供更好的电子阻挡效果。实验研究了EBL厚度对绿光LED效率的影响。
在Si衬底上生长了7个EBL厚度为20nm至60nm的绿光LED,EBL的Al含量固定在20%。样品的EQE如图7所示。在低电流密度下,具有最薄EBL的样品具有最高的效率。在高电流密度下,具有最高EQE的GaN LED具有50nm的EBL厚度。
EBL可以抑制电子溢出,这有利于效率,但也增加了空穴注入的难度,对效率产生了负面影响。在低电流密度下,当电子溢出不严重时,EBL对空穴注入只有负面影响;因此具有最薄EBL的GaN LED具有最高的效率。在高电流密度下,当EBL厚度小于50nm时,电子阻挡的正影响占主导地位;但是当EBL厚度增加到60nm时,对空穴注入的负面影响变得占主导地位。因此,用于绿光LED的最佳EBL厚度被设置为50nm。

图7 具有不同EBL厚度的绿光LED的EQE
通过将各项技术集成,研究人员成功地在Si衬底上获得了高质量、高效率、高功率的绿色LED,这些LED已经在商业上可用。图8绘制了不同波长的绿色LED在不同温度下的内量子效率(IQE)曲线。在35A/cm2和室温下,515nm、520nm和525nm波长的绿色LED的IQE分别达到45.2%、42.5%和41.6%,与蓝宝石和SiC衬底上的最佳结果处于同一水平。在高达566 nm的较长波长范围内,在Si衬底上生长了具有9.4%EQE的高功率黄色LED,这与AlGaInP黄色LED具有竞争力。随着进一步的改进和优化,认为硅基GaN基LED在绿色光谱区域应该有光明的前景。
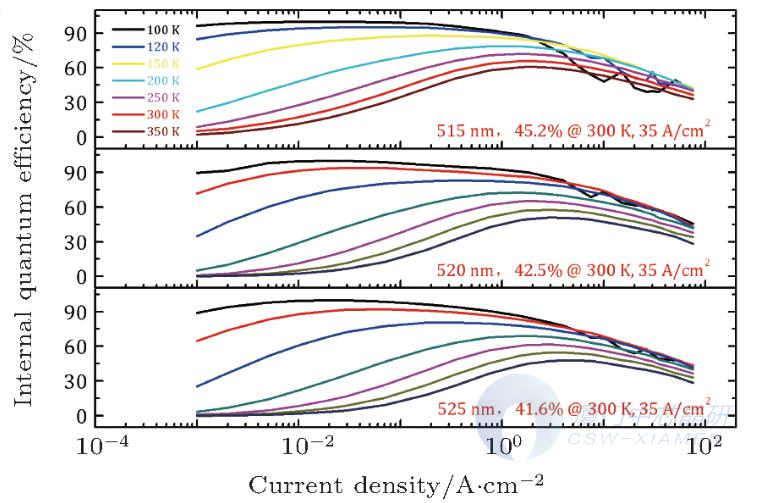
图8 不同波长的硅基绿光LED在不同温度下的IQE曲线
更多氮化镓绿光LED晶片信息或疑问,请邮件咨询:vp@honestgroup.cn
