光学级与外延级N、P型单晶锗(Ge)片
单晶锗(Ge)材料是一种重要的硬脆红外光学材料,属于具有高空穴迁移率和电子迁移率的间接过渡半导体,广泛应用于航空航天、高频超高频电子、光纤通信、红外光学、太阳能电池等领域。可提供从2英寸到8英寸的单晶锗片,具体以8英寸N型锗片为例:
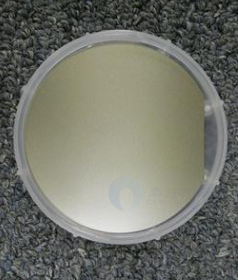
1. 8英寸单晶锗片规格参数
| 产品 | 单晶锗(Ge)片 |
| 直径 | 8英寸(200 mm) |
| 电导率 | N/A(undoped) |
| 厚度 | 725+/-25um |
| 标准notch | 110 |
| 电阻率 | >1ohm.cm |
| GBIR/TTV | 15um max (base on WEE: 5mm) |
| Bow/Warp | 50um max (base on WEE: 5mm) |
| Particle(>=0.2um) | 30 max |
| 表面处理 | 双面抛光 |
| 金属污染 (Al, Ca, Cr, Cu, Fe, Na, Ni, Zn) | <2E10 atoms/cm2 |
2. 非本征锗单晶电阻率与杂质浓度的关系
单晶锗在室温下为n型,电阻率与温度呈非单一依赖关系。当导电类型从n型转变为p型时,锗单晶电阻率最大,载流子迁移率下降。随着掺杂浓度的增加,从内部到外部的转变移动到室温,并反映了晶体的纯度水平。在不同浓度硼掺杂的高纯锗单晶中也发现了类似的趋势。发现单晶锗片中杂质带与本征载流子的温度依赖性和导电性原理的相互作用导致受体浓度较低(<1012/cm3)。对于非本征半导体,材料的电阻(电导率)主要与多数载流子浓度和迁移率有关。图1显示了杂质锗晶片的电阻率和浓度之间的变化:

图1 室温条件下,N、P型锗单晶电阻率与浓度的关系曲线
3. 锗片电阻率的测量
锗单晶在生产过程中经常受到速度和固液界面的影响。锗单晶电阻率分布往往不均匀,电阻率的均匀性直接影响器件的可靠性和成品率。为了提高锗片的成品率,对单晶电阻率的径向均匀性提出了更严格的要求。直流四探针法测量电阻率在半导体材料的研究和生产中发挥着重要作用,是最广泛的测试方法之一。
直流四探针适用于测量样品的厚度和从样品边缘到任何探针末端的最近距离,两者都大于探针节距的电阻率的4倍,测量直径大于探针节间距的10倍。单个锗晶片的电阻率小于探针间距的4倍。测量范围为1X10-3ohm.cm~1X102ohm.cm。
测量原理:排列成一直线的四探针垂直压在半无穷大的试样平坦面上。外探针1、4间通电流I(A),内探针2、3间电压U(V)。在满足一定条件下,四探针附近试样电阻率ρ可用公式(1)或公式(2)计算:

式中:
l:探针系数
l1:探针1、2间的距离,单位为cm
l2:探针2、3间的距离,单位为cm
l3:探针3、4间的距离,单位为cm
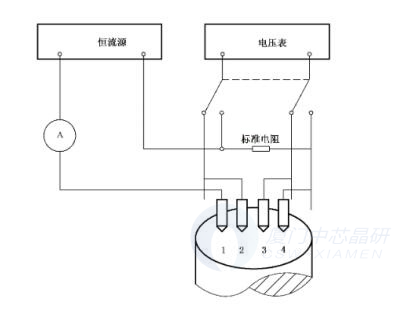
图2 四探针法测量原理示意图
更多锗片信息或疑问,请邮件咨询vp@honestgroup.cn
