GaN体晶片和GaN模板衬底上生长的AlGaN/GaN异质结构的高迁移率二维电子气*
1. 概述
AlGaN/GaN界面的二维电子气(2DEG)由于其在GaN基高电子迁移率晶体管中的应用而得到了研究。2DEG不需要有意的调制掺杂来诱导形成,而是通过氮化物异质结上的自发极化和压电极化的差异来实现的。这对AlGaN/GaN 2DEG来说是一个优势,因为它可能消除有意掺杂剂的散射。
本工作旨在研究位错散射对低密度AlGaN/GaN 2DEG低温迁移率的影响。我们在具有非常低位错密度的单晶GaN体晶片和具有高位错密度的GaN模板上同时生长了两个不同系列的AlGaN/GaN异质结构,并比较了迁移率。发现迁移率直接取决于2DEG电荷密度,但位错不会对测量区域内样品的迁移率造成明显影响。
2. 样品制备
本研究选择两种位错密度对比鲜明的衬底来研究位错散射对迁移率的影响:
1)位错密度为~5×104cm−2的半绝缘单晶GaN(0001)体晶片,Mn掺杂;
2)位错密度为~1×108cm−2的蓝宝石衬底上半绝缘GaN模板,Fe掺杂(来自中芯晶研)。
对于每个外延生长过程,使用Si载体支架上的铟并排装载每种尺寸为7×7mm2的切割衬底,以保证相同的生长条件。本研究中的所有样品都在Veeco Gen10 MBE反应器中生长,该反应器配备有用于元素Ga和Al的标准渗出池,以及用于活性N物种的射频等离子体源。在怠速条件下,生长室的基本压力在10−10 Torr的范围内;在生长过程中,主要由于N2气体,基本压力为2×10−5 Torr。二次离子质谱(SIMS)对在该室条件下生长的单独的非故意掺杂GaN层的测量显示,非故意的背景氧水平为~1×1016cm-3。
生长了两个系列的样品,结构如图1所示:
系列1 的生长结构从衬底开始:[300 nm GaN]/[21 nm AlxGa1−xN]/[3 nm GaN帽层];
系列2的生长结构从衬底开始:[300 nm GaN]/[XXnm Al0.03Ga0.97N]/[3 nm GaN帽层]。
通过改变系列1中AlxGa1-xN的Al组分x(0.07<x<0.23)或通过改变系列2中Al0.03Ga0.97N层厚度t(t=42、63和84nm)来改变在AlGaN/GaN界面处形成的2DEG密度。
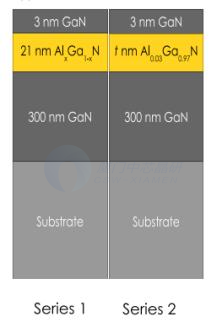
图1 系列1和2的样品AlGaN/GaN结构示意图
3. 结论
本研究发现位错密度在4个数量级以上的变化对AlGaN/GaN异质结构处的低密度2DEG的低温(77K)迁移率没有明显影响。这表明,位错以外的散射机制可能是限制这种异质结构中低温迁移率的原因。因此,有必要进行进一步的生长和表征研究,以消除散射机制的作用,了解位错密度对迁移率的真实影响,并在未来实现低密度氮化物2DEG中更高的低温迁移率。
更多GaN模板产品信息或疑问,请邮件咨询:vp@honestgroup.cn
