GaN p-n二极管和 InGaN 蓝光发光二极管(LED )的偏振增强型 InGaN/GaN 混合隧道结接触*
1. 概述
通过使用分子束外延在金属有机化学气相沉积生长的极化增强的p型InGaN接触层上沉积高Si掺杂的n型GaN,实现了提高的导通电压和降低的串联电阻。比较了不同Si掺杂浓度和添加p型InGaN对p–n二极管和发光二极管正向电压的影响,发现将Si浓度从1.9×1020 cm-3增加到4.6×1020 cm-3,并在结处包括高掺杂的p型InGaN,都有助于减小耗尽宽度、4.2×10-3~3.4×10-3Ω/cm2的串联电阻和二极管的导通电压。
2. 样品制备
本工作采用来自中芯晶研的MOCVD法生长的InGaN蓝光(445nm)LED晶片进行研究,具体结构如图1(a)和1(b)所示,并指示了相应的厚度和掺杂剂浓度。对于这些实验,使用了两种类型的高掺杂p型覆盖层:Mg浓度为9×1019 cm−3的高掺杂12 nm p+GaN层、含有15%In的5 nm p+InGaN层和Mg浓度相似的7 nm p+GaN层。在MBE再生之前,将样品在600°C的空气中活化15分钟,并在缓冲HF中浸渍1分钟,以去除多余的表面Mg和O.19)对于所研究的LED样品,在再生长之前也将其浸渍在缓冲HF。
pGaN和(b)pInGaN覆盖层的GaN-p–n二极管外延结构示意图.png)
图1 具有(a)p+GaN和(b)p+InGaN覆盖层的GaN p–n二极管外延结构示意图
利用混合方法通过在使用MOCVD生长的p+GaN和p+InGaN材料上沉积通过MBE生长的Si掺杂的n-GaN外延层来创建隧道结接触,以确定引入InGaN层和改变Si浓度对降低器件中的过多电压的影响。此外,比较了在隧道结再生生长界面处含有不同浓度Si的InGaN基蓝色LED的性能。
然后将p–n二极管和LED晶片加载到Veeco 930 NH3 MBE工具中,并在再生长前在400°C下脱气1小时。使用Ga和Si的固体源渗出池和200sccm的NH3流速在700°C下进行n型GaN再生长。通过减少生长过程中入射的Ga通量来改变n++GaN:Si层中的Si浓度。所用Ga通量的束流当量压力分别为1×10−7、6×10−8、4×10−8和2×10−8Torr,对应于图2中的Si浓度1-4。调整所使用的每种Ga通量的生长时间,以保持本工作中比较的所有样品的层厚度相同(15nm)。在Cameca IMF 7f系统中,通过二次离子质谱(SIMS)测量隧道结样品中的Si浓度。
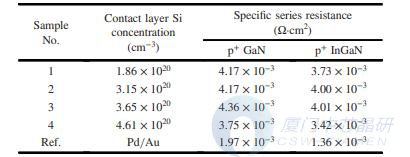
图2 本研究中样品的隧道结n+侧的Si浓度
将台面结构蚀刻到p–n二极管和LED结构中,以暴露n+GaN接触层。在台面蚀刻之后,在用于二极管和LED器件的底部MOCVD和顶部MBE n+GaN层上沉积共同的Ti=Al=Ni=Au接触。使用四点探针配置,在台面半径为100µm、顶部金属接触半径为80µm的p–n二极管上进行电流-电压测量。金属覆盖率为p–n二极管顶部接触面积的64%。对于LED,测量晶片上处理过的LED的光输出功率(L)、电流(I)和电压(V)。LED的台面和金属顶部接触面积分别为0.1和0.01mm2。将具有MBE 隧道结触点的p–n二极管和LED置于300A/cm2的老化电流下5 s,以对触点进行退火。在30A/cm2下测量所有样品的串联电阻。
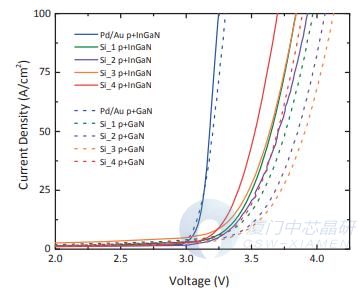
图3 具有不同Si浓度p+GaN或p+InGaN覆盖层的p–n二极管的I–V特性曲线
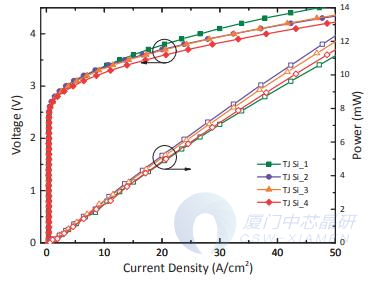
图4 具有不同Si浓度的MBE隧道结的LED的L–I–V特性曲线
3. 结论
本研究表明,通过增加Si掺杂剂浓度并在隧道结接触的p–n界面引入p+InGaN,可以减少电子进行带间传输所需的隧道宽度。这降低了p–n和LED二极管的电阻损耗。
更多GaN LED二极管外延片信息或疑问,请邮件咨询:vp@honestgroup.cn
