不同铟(In)含量和不同阱宽的InGaN/GaN基蓝光发光二极管(LED)的电致发光特性
可供InGaN/GaN多量子阱基发光二极管(LED)外延片,具体晶片信息请咨询:vp@honestgroup.cn
1. 概述
制备了两种基于InGaN/GaN多量子阱(MQW)的蓝光发光二极管(LED),它们发射的光子波长大致相同,铟含量和阱宽度不同,并研究了它们在不同固定注入电流下的电致发光(EL)光谱的温度依赖性。
结果表明,与铟含量较低、阱宽较大的InGaN/GaN LED芯片B相比,铟含量较高、阱宽较小的InGaN/GaN LED芯片A在较低的固定电流下具有较强的载流子局域化效应和较高的外量子效率(EQE);然而,在增加注入电流时,LED芯片A的局部化效应和EQE都以更快的速率减小。前者主要归因于较高的铟含量引起的较大的铟波动导致的更深的电势水平,以及较小的阱宽度引起的更强的载流子量子限制效应(QCE);后者主要归因于由较小的阱宽度和较大的晶格失配引起的更强的压电场引起的电子泄漏和/或电子溢出的更显著增长,以及由较小阱宽度引起的高能局域化态密度较小引起的载流子局域化效应的更显著降低。
2. 样品制备
使用金属有机化学气相沉积(MOCVD)在(0001)取向的蓝宝石衬底上生长了两种不同的InGaN/GaN MQW基蓝光LED外延结构,具体生长结构如下表所示:
| 外延层 | 厚度 |
| Mg掺杂p-GaN接触层 | 200nm |
| Mg掺杂p-AlGaN电子阻挡层 | 20nm |
| InGaN/GaN MQWs(10周期) | * |
| Si掺杂GaN | 3um |
| 非故意掺杂GaN | 3um |
| GaN缓冲层 | 25nm |
| 蓝宝石衬底 |
对于InGaN/GaN多量子阱,LED外延结构A的InGaN阱层厚度为2.6nm,In含量为15.0%;而LED外延结构B的InGaN阱层为3.4nm,In含量为12.8%。使用传统的台面结构方法制造了面积为1.16mm2的LED芯片。
对于不同固定注入电流下的温度相关EL测量,将芯片安装在温度可变的闭合循环He低温恒温器中的Cu冷台上,以在6–300K的范围内改变样品温度 。采用Keithley 2400电流表作为激励电流源,电流范围为0.01–200 mA。 LED芯片的EL信号由Jobin-Yvon iHR320单色仪分散,并由热电冷却的Synapse CCD检测器检测。

图1 InGaN/GaN LED芯片A和B在300 K下的200mA EL光谱;插图显示了LED芯片A和B之间的波长差 (Δ λ ) 作为 300 K 下注入电流的函数
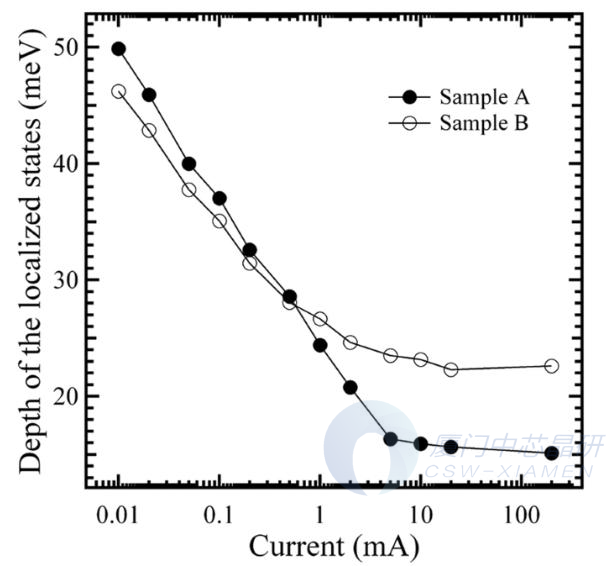
图2 InGaN/GaN量子阱LED芯片A和B的局域态深度与注入电流的函数关系

图3 InGaN/GaN LED芯片A ( a ) 和 B ( b ) 的 MQW 结构中载流子分布的可能状态。虚线表示芯片B中局域态的最低能级。虚线I和II分别表示在较低和较高注入电流下注入载流子填充的局域态的最高能量

图4 InGaN/GaN基蓝光LED芯片A ( a ) 和 B ( b )的相对外量子效率 (EQE) 的温度依赖性,在 0.01、5、50、100 和 200 mA 下测量
3. 结论
为了生产发射固定波长光子的高性能InGaN基LED,生长了两个具有不同铟含量和阱宽度的InGaN/GaN MQW基蓝光LED芯片,并研究了它们在不同注入电流下的EL光谱的温度依赖性。结果表明:
1) 与具有较低铟含量和较大阱宽度的LED芯片B相比,具有较高铟含量和较小阱宽度的LED芯片A由于其源自较高铟含量的较大铟波动而在较低电流下显示出较强的载流子局域化效应,但由于其源自较小阱宽度而产生的高能局域化态密度较小而在较高电流下表现出较弱的载流子局域化效应;
2) 与LED芯片B相比,LED芯片A的EQE与温度曲线显示在最低注入电流0.01mA时EQE值较高,从0.01mA开始增加注入电流后以更快的速度逐渐下降:前者主要是由于其更强的载流子局域化效应上面,以及源自较小阱宽度诱导较强载流子 QCE 的电子和空穴之间较大的波函数重叠;后者主要归因于由于较小的阱宽度和较大的晶格失配引起的更强的压电场,其电子泄漏和/或电子溢出的增长更为显着,以及由于较小的阱宽度而导致的载流子局域化效应的降低更为显着。阱宽度导致高能局域态密度较小。
所有的实验结果表明,具有固定发射波长的MQW结构的综合光学性能实际上主要是铟含量和阱宽度以及注入电流之间竞争的结果,因此探索合适的铟含量和阱宽对于提高此类InGaN/GaN基LED的光学性能至关重要。
更多InGaN/GaN基LED晶片信息或疑问,请邮件咨询:vp@honestgroup.cn
