AlGaN/GaN 异质结构场效应晶体管(HFET)外延片 *S
场效应晶体管(FET)本质上是半导体电流路径,其电导通过施加垂直于电流的电场来控制。该场和半导体沟道中的载流子密度通过施加在金属栅极上的电压而改变。沟道中的电子越多,其导电性就越高,晶体管的性能也就越好。此外,随着异质结构科学和技术的发展,异质结场效应晶体管(HFET)在微波、毫米波和高速数字集成电路应用中比以前的同质结器件具有潜在的优势。可供AlGaN/GaN异质结构场效应晶体管(HFET)外延片,具体外延参数如下所示仅供参考:
1. AlGaN/GaN异质结构场效应晶体管外延结构
| 外延材料 | 厚度 |
| Undoped AlGaN | – |
| N-AlGaN | – |
| Undoped AlGaN | – |
| Undoped GaN | 1um |
| LT-GaN | – |
| Sapphire sub |
2. 关于AlGaN/GaN 异质结构场效应晶体管
AlGaN/GaN异质结构场效应晶体管(HFET)由生长在窄带隙材料(即GaN,为沟道层)顶部的宽带隙材料(例如AlGaN,为势垒层)组成。由于势垒和沟道层之间的导带不连续性,将在异质界面的GaN侧形成三角形量子阱,如图1所示。
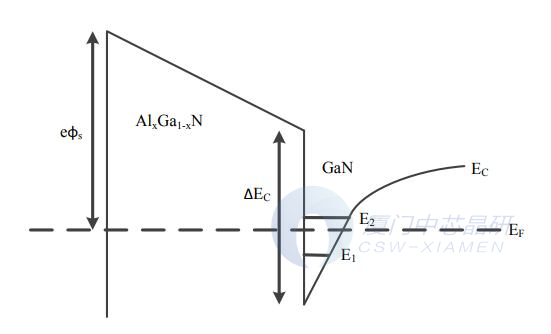
图1:AlGaN/GaN HFET的导带示意图(ΔEC是异质界面处的导带不连续性,E1和E2是三角形量子阱的第一和第二子带,eφs是肖特基势垒高度)
非极性HFET的沟道中的电子浓度源是高掺杂的宽带隙势垒层。在这些异质界面处的能带弯曲导致电荷载流子从势垒迁移到在沟道层中形成的三角形量子阱。由于2DEG电子被限制在三角形量子阱中,因此在这种结构中电子迁移率将增强。
2.1 HFET材料生长与器件制备
由于缺乏商业上可行的GaN衬底,AlGaN/GaN HFET通常在SiC或Sapphire衬底上制造。在这些晶格失配衬底上的晶体生长过程中,使用AlN和GaN成核和缓冲层来最小化位错数量。薄AlGaN势垒层是在弛豫的GaN沟道层的顶部上伪态生长的。根据拉伸应变生长模式,单向自发极化和压电极化有助于在AlGaN/GaN异质界面处形成2DEG。由于存在足够的2DEG诱导源,在AlGaN/GaN HFET的制造过程中通常不存在有意掺杂。
合金欧姆接触将源极和漏极直接连接到2DEG,栅电极形成肖特基接触并且位于源电极和漏电极之间。与MOSFET不同,AlGaN/GaN HFET通常被实现为非自对准器件。栅极-漏极间距的存在对于增加这些晶体管的击穿电压是非常重要的。因此,AlGaN/GaN HFET的沟道由源极访问区域(即,源极电极和栅极电极之间的间隔)、门控沟道和漏极访问区(即,栅极电极和漏极电极之间的间距)组成。
2.2 二维电子气(2DEG)的产生
在AlGaN势垒和GaN沟道层的单向自发极化的强度之间存在相当大的不连续性。由于这些自发极化之间的差异,在金属面AlGaN/GaN异质结构的GaN侧感应出负极化电荷浓度。这种极化电荷是AlGaN/GaN HFET中2DEG形成的部分原因。
除了AlGaN和GaN之间自发极化的失配之外,在AlGaN/GaN异质界面处还存在压电极化。由于AlGaN和GaN之间的晶格失配,在GaN沟道层顶部的AlGaN势垒的伪晶生长中,在异质界面处建立拉伸应变。这种内置应变的存在和III族氮化物的大压电系数导致了相当大的压电极化的诱导。金属面AlGaN/GaN HFET中该极化矢量的方向与自发极化相同,如图2所示。在非故意掺杂的金属面AlGaN/GaN HFET的异质界面处形成高2DEG载流子浓度是AlGaN和GaN之间自发极化不连续的净结果,以及这种大的压电极化。
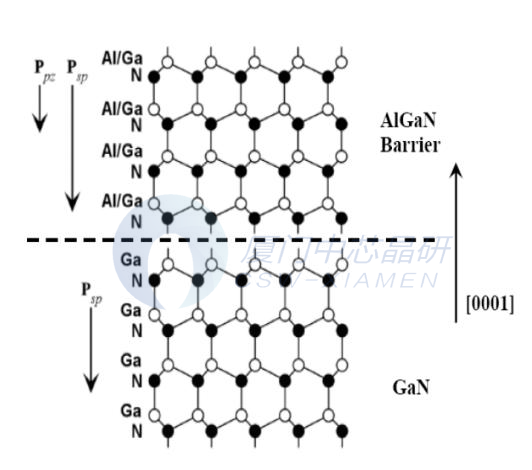
图2:金属面AlGaN/GaN HFET中的自发极化和压电极化(Psp表示自发极化,Ppz表示压电极化)
3. AlGaN/GaN HFET与其他类型的HFET相比有什么优势?
AlGaN/GaN HFET作为一种在功率电子、射频以及在数字、超高温和超低温电子领域的应用中显示出众多优势的技术,越来越被广泛接受。由于其独特的材料特性,包括宽带隙和优异的传输参数,GaN可以满足包括深井钻探、汽车和航空航天在内的各种工业应用的高温、高频和高功率需求。同时,AlGaN/GaN HFET可以在与超导和量子计算应用相关的非常低的温度环境中工作。
更多外延片信息或疑问,请邮件咨询:vp@honestgroup.cn
