4H-SiC中自旋活性色心未掺杂光学膜的剥离研究 *
1. 摘要
碳化硅(SiC)是一种用于量子信息处理、微机电系统、光子学、电力电子和恶劣环境传感器的半导体材料。然而,其高温稳定性、高击穿电压、宽带隙和高机械强度也伴随着化学惰性,这使得复杂的微加工变得困难。光电化学(PEC)蚀刻是一种简单、快速的SiC湿法加工方法,其中包括利用成熟的碳化硅同质外延技术实现掺杂选择性蚀刻停止。然而,掺杂剂选择性PEC蚀刻通常依赖于高掺杂材料,这给量子缺陷和光子学等器件应用带来了挑战,这些器件应用受益于低掺杂以产生稳健的发射极特性和高光学透明度。
在这项工作中该工艺不依赖于高掺杂,而是基于制造二极管结构的电耗尽效应,实现了对n掺杂的衬底晶片进行选择性蚀刻,而非未掺杂的外延(载流子密度为1(10)14cm-3)器件层的选择性蚀刻。表征了二极管在偏压下的光响应和PEC行为,并利用这些见解成功悬浮了大型未掺杂的SiC膜(100×100μm)。研究人员进一步表征了膜与量子发射体的相容性,在未掺杂和高掺杂的膜结构之间进行了比较自旋光谱分析,发现使用未掺杂材料可使整体自旋寿命提高5倍以上。这项工作能够制造适用于SiC中可扩展的光子学、力学和量子技术的高纯度悬浮薄膜。
2. 样品制备
使用来自中芯晶研的n型4°切割c轴衬底上的未掺杂SiC外延层(500nm)进行研究。通过在衬底背面热蒸发200纳米的镍,随后在氩气气氛中于950°C下进行快速热退火,实现与衬底的接触。
为了测定外延层的载流子浓度,首先通过热蒸发的方式在外延层上沉积铝,并在样品中心留下一个直径为2mm的圆形未覆盖区域作为掩膜。随后去除掩膜,暴露出下方的未掺杂的SiC外延层,并在氩气环境中快速热退火形成接触。接着,将样品浸入2M的氯化钾(KCl)溶液中,同时用硅胶O型圈覆盖铝接触点。
对于光电化学(PEC)蚀刻和电容-电压(CV)测量,采用溅射法以一定速度沉积一层100纳米厚的透明氧化铟锡(ITO)顶部电极,并在沉积过程中将衬底温度逐渐升至600°C。
在制备薄膜时,首先通过正性光刻胶(PMMA495 C6)电子束在ITO层上定义出mesa结构。然后,使用电感耦合等离子体反应离子刻蚀(ICP-RIE)技术,在3:1的氢气与四氟化碳(H2:CF4 )混合气体中刻蚀,将图案转移到ITO层上。接着,使用4:1的六氟化硫与氧气(SF6:O2 )混合气体进行ICP-RIE刻蚀,将图案进一步转移到SiC中,刻蚀深度为2um。
光电化学(PEC)蚀刻在40至500mM的氢氧化钾(KOH)电解液中进行,电解液从10°C的储液槽中持续循环,以确保电解液浓度恒定并带走废热,且未添加支持电解质。对电极采用卷绕的铂丝,参比电极则为3MKCl溶液中的银/银氯化物(Ag/AgCl)电极。
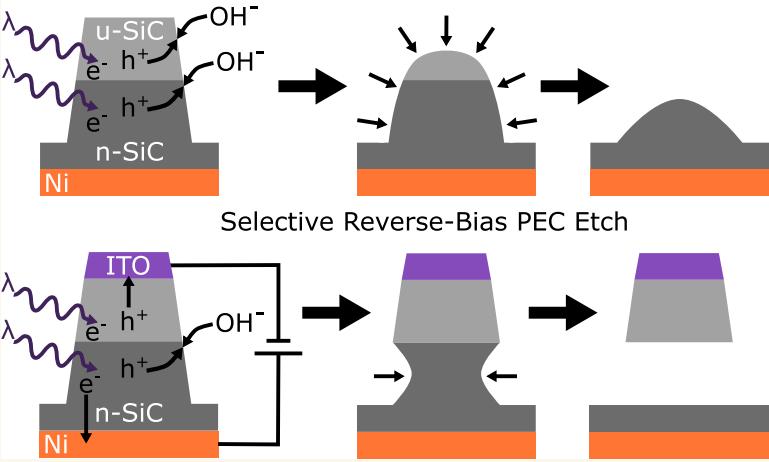
图1 选择性反向偏压PEC蚀刻
3. 结论
本工作展示了一种掺杂剂选择性PEC蚀刻方法,该方法显著放宽了对掺杂密度的限制,以实现蚀刻选择性,从而能够悬浮低表面粗糙度、大面积的膜,改善电荷噪声环境,以容纳量子发射体。这种方法通过添加常用的硬掩模(ITO)和偏置外延层和衬底之间形成的结的电路,将SiC中高纯度、PEC悬浮光子学和力学所需的外延步骤减少到一个步骤。
此外,研究了SiC二极管在外部偏压下的光电化学特性,并表明未掺杂碳化硅的光滑膜可以以超过4μm·h-1的速率悬浮。我们还注意到,所展示的500 nm器件层是由外延生长定义的,因此可以灵活地改变以适应应用。该技术可用于可控地将SiC薄膜转移到其他衬底,例如硅片上的氧化硅,或用于精确地薄化已键合的SiC材料。最后,对悬浮的掺杂和未掺杂材料进行了比较自旋光谱分析,证明未掺杂材料有益地减少了快速自旋噪声对量子缺陷的影响,并且与PEC处理兼容。
该工作开发出一种可靠悬浮大面积未掺杂碳化硅(SiC)薄膜的方法,为利用4H-SiC的高屈服强度于纳米机械振荡器以及将量子发射器集成到电子和光子器件中的应用开辟了新途径。此外,该技术放宽了对掺杂选择性蚀刻的材料限制,提出了一种选择性蚀刻其他惰性材料的方法,这些材料中仅能可靠地形成单一掺杂类型,例如金刚石。
更多SiC外延片信息或疑问,请来邮咨询:vp@honestgroup.cn
