12MeV硅离子辐照制备InGaN/GaN多层薄膜的结构和光学特性 *
1. 概述
本文研究了硅(Si)离子辐照(12MeV高能)对InGaN/GaN薄膜结构和光学特性的影响。在1×1013至1×1015ions/cm2范围内的不同Si离子通量下进行辐照。原始薄膜的X射线衍射(XRD)图谱仅显示InGaN的(0 0 2)取向晶粒,而辐照后的薄膜图谱也显示其他相(InN和GaN)。不同剂量率下的离子辐照对InGaN的晶粒尺寸没有显示出影响或可忽略不计,除了峰值位置的偏移,这表明拉伸应力的发展。在辐照的膜图案中存在其他相是InGaN相分离的指示。拉曼光谱中669 cm-1处的峰移和新峰的出现也证实了由于辐照而产生的缺陷。本文报道了光学带隙随离子辐照剂量率的增加而减小的现象。
2. 样品制备
采用来自我司的蓝宝石衬底上生长的InGaN/GaN薄膜进行实验。将生长的薄膜暴露于由安装在5UDH-2 Pelletron串联加速器提供的12.0MeV能量的Si离子准直束中。在辐照过程中,真空度保持在10−6Torr。使用物质代码中离子的停止/范围,发现InGaN中12 MeV Si离子的投影范围约为4.08µm。该范围保持远大于膜厚度,以确保均匀的损伤分布。将InGaN/GaN晶片安装在高精度测角仪上,以便可以精确控制样品相对于硅离子束的取向。实验在1×1013、1×1014和1×1015ions/cm-2的不同离子通量下进行。第四个InGaN/GaN外延片未经辐照,作为参考样品。
利用X射线衍射(XRD)和拉曼光谱对原始薄膜和辐照薄膜进行结构分析。使用Bruker X射线衍射仪,在40kV、40mA和25°C的温度下,使用Cu-Kα(λ=1.54191Å)辐射,在20°至80°的2θ范围内收集XRD数据,步长为0.02°。利用卢瑟福背散射光谱(RBS)对元素组成进行了定量和定性研究。拉曼光谱由LabRAM III使用波长为514nm的150mW氩离子激光器收集。对于光学特性,使用了紫外-可见分光光度计。
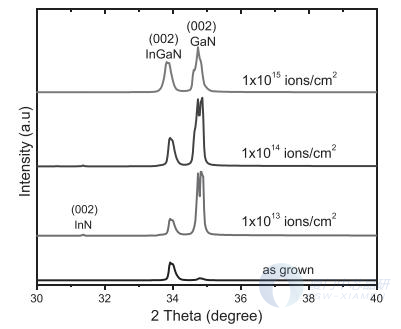
图 1 InGaN/GaN原始外延层和Si+辐照外延层在不同通量下的XRD光谱
-InN峰值强度随剂量率的变化;(b)InGaN在不同Si离子通量下的峰移.png)
图2(a) InN峰值强度随剂量率的变化;(b)InGaN在不同Si离子通量下的峰移
-InGaNGaN生长态和Si束辐照膜的拉曼光谱(b)拉曼E2h带FWHM的变化.png)
图3 (a) InGaN/GaN生长态和Si束辐照膜的拉曼光谱(b)拉曼E2h带FWHM的变化
未辐射晶片光谱;分别以(b)1×1013(c)1×1014和(d)1×1015ionscm2照射光谱.png)
图4 RBS光谱:(a)未辐射晶片光谱;分别以(b)1×1013(c)1×1014和(d)1×1015ions/cm2照射光谱
与波长的关系.png)
图5 不同剂量率下的透射率(%T)与波长的关系
计算的InGaN薄膜的带隙能量;(b)带隙随剂量率的变化.png)
图6 (a)计算的InGaN薄膜的带隙能量;(b)带隙随剂量率的变化
3. 结论
该研究表明,在InGaN/GaN外延层系统中,Si+辐照(12MeV高能)不仅产生结构变化,而且影响光学性能。
在XRD图谱中,InGaN衍射峰在较大的离子通量下从原始位置向较高的角度移动。它还表现出InGaN相的峰值分裂,表明InGaN相在生长态膜中的偏析。Rutherford反向散射光谱技术表明,辐照膜的厚度和组成保持不变,表明InGaN膜的辐射耐受性。蓝宝石基GaN晶片的拉曼光谱在567 cm-1和736 cm-1处显示两个峰,对应于E2h和A1(LO)声子模式。由于离子束在高通量下引起的晶格损伤,离子辐照在拉曼光谱中的669 cm-1处也引起了一个新的峰值,这与XRD结果一致。
更多蓝宝石基InGaN/GaN晶片信息或疑问,请邮件咨询:vp@honestgroup.cn
